
原子堆叠,构筑未来
————— 原速科技
技术介绍
早在20世纪60年代,苏联科学家在开展催化剂和吸附剂表面修饰研究时发现在硅胶表面生长的TiO2具有自限制特性,提出 “分子层”概念。20世纪70年代芬兰科学家建立了第一个原子层外延(atomic layer deposition,ALE)沉积系统,成功沉积了ZnS、SnO2、GaP,并因此在1977年获得了世界上第一个原子层沉积(atomic layer deposition,ALD)的发明专利。

原子层沉积(ALD)原理图
什么是原子层沉积?
原子层沉积(atomic layer deposition, ALD)是通过气相前驱体及反应物脉冲交替的通入反应腔并在基底上发生表面化学反应形成薄膜的一种方法,通过自限制性的前驱体交替饱和反应获得厚度、组分、形貌及结构在纳米尺度上高度可控的薄膜。该方法对基材不设限,尤其适用于具有高深宽比或复杂三维结构的基材。采用ALD制备的薄膜具有高致密性(无针孔)、高保形性及大面积均匀性等优异性能,这对薄膜的使用具有重要的实际意义。
通过原理图可以发现ALD并非一个连续的工艺过程,而是由若干半反应序列组成。步骤一中前驱体在基底表面发生化学吸附反应A ,步骤三中反应物与已经吸附了前驱体的基底继续进行表面化学反应B,步骤二、四用惰性气体把多余气体和副产物带出反应腔。A、B两个半反应具有自限制和互补性特点,四个步骤依次循环决定了薄膜的厚度。
原子层沉积的特点有哪些?
不同于传统的化学气相沉积,ALD具有表面自限制的特点,因此在众多薄膜制备技术中脱颖而出,展示出独树一帜的优势!
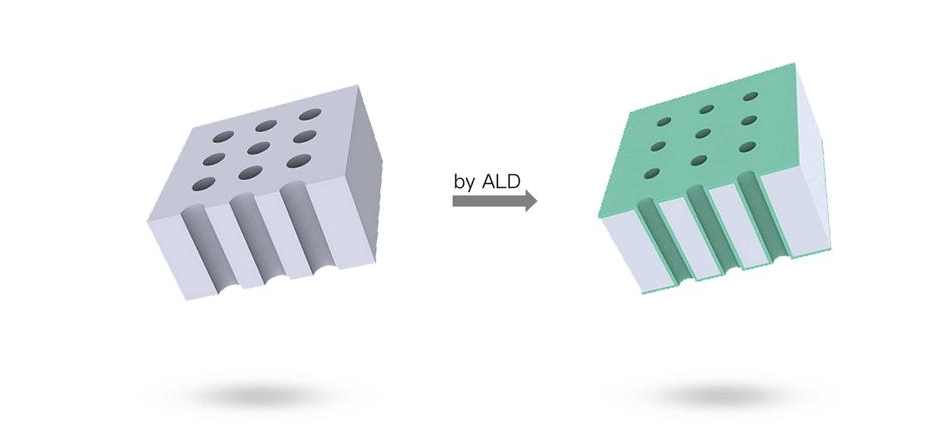
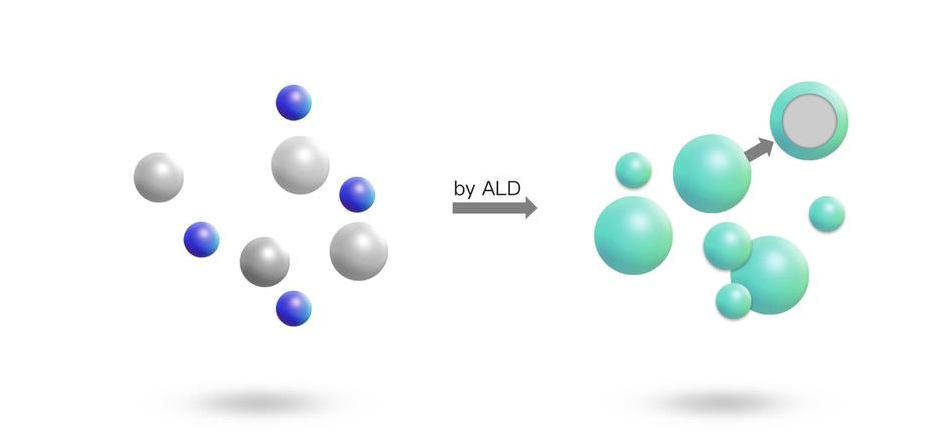

薄膜特性判断
通过调节反应循环次数精确控制薄膜厚度,形成原子级厚度的薄膜
薄膜沉积温度友好,RT~400℃
可广泛适用于各种形状的衬底,在高深宽比结构及其他复杂三维结构中可也生成保形性极好的薄膜
前驱体或反应物是饱和的化学吸附,能保证生成大面积均匀性的薄膜
基于自限制特性,ALD过程不需要控制前驱体或反应物流量的均一性
薄膜光滑、致密、无针孔
适合界面修饰和制备多组元纳米叠层结构
具备规模化生产能力
- 联系我们深圳市宝安区西乡街道蚝业社区大铲湾蓝色未来科技园二期2栋2层www.superald.com0755-23216544 / 18026941256

关于我们
公司简介
产品介绍
招贤纳士
技术服务
产品中心
研发中心
镀膜加工
联系我们
180-2694-1256
info@superald.com
原速科技 · 深圳市宝安区西乡街道蚝业社区大铲湾蓝色未来科技园二期2栋2层
Copyright © 2022 SuperALD All rights reserved.
原子层沉积_光学镀膜_纳米涂层_ALD_CVD_PVD-原速科技SUPERALD
原速科技(Superald,LLC)是一家专注于开发新一代ALD原子层沉积(Atomic Layer Deposition, ALD)技术的高科技企业,为CVD,PVD,光学镀膜,钝化层,纳米涂层,卷对卷设备,薄膜材料,微纳加工及锂电池包覆等领域的薄膜研发和生产提供优质的技术服务和一体化解决方案,致力打造全球一流的薄膜材料制备平台.
https://user-assets.sxlcdn.com/images/959379/FqlHwzZrHo5fWDMyVunRtE9C8CNu.png?imageMogr2/strip/auto-orient/thumbnail/1200x630>/format/png



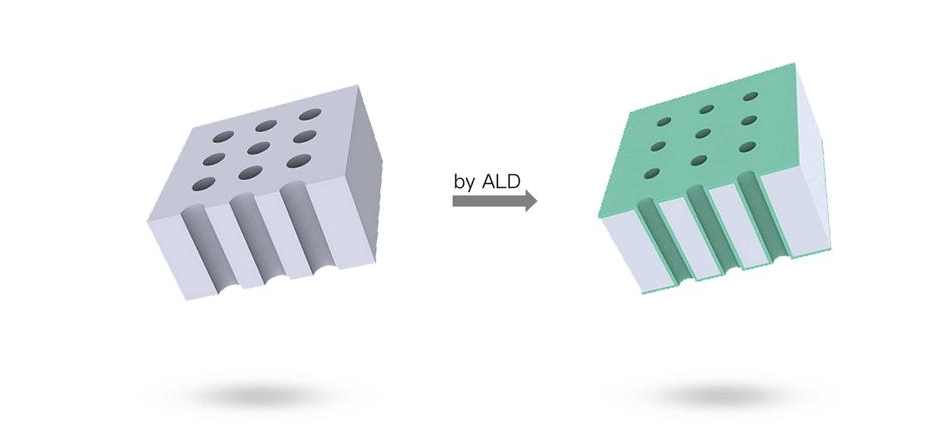
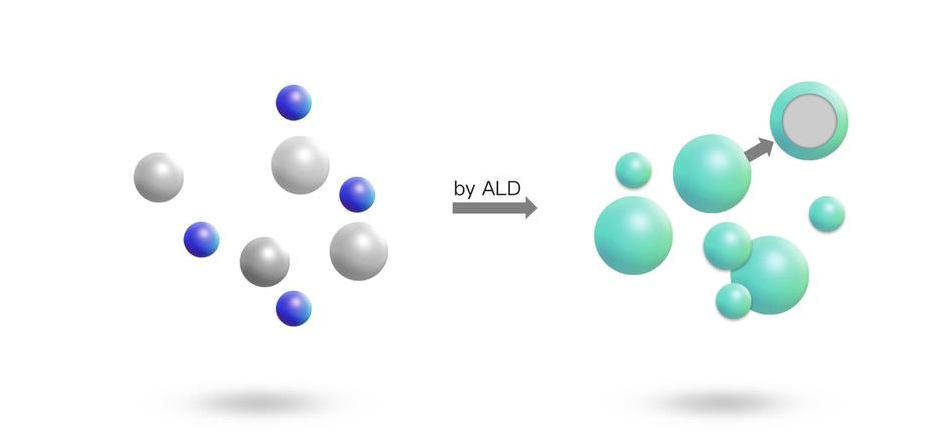

 粤公网安备44030602006772号
粤公网安备44030602006772号